DIC技术在芯片高低温变形测量中的应用
商业 来源: 2021/6/21 23:52:47 阅读:1423随着智能手机、5G、物联网等技术的快速发展,芯片的发热功率急剧上升,与此同时,手机等设备外观要求超薄,导致设计上的散热空间极为有限,芯片温度控制难度极大。热应力容易导致CSP芯片晶圆翘曲,严重时会产生开裂现象。

由于手机芯片尺寸较小,在温度循环下的热应力较难通过传统的应变测试方法获取,因此需要采用DIC技术的方法进行应变测量,从而更好地分析芯片通电后的热应力分布情况,分析芯片导电、温度控制、散热等相关性能。
新拓三维XTDIC应变测量分析系统,作为研究芯片在不同温度下变形分析的重要测量工具,特别适用于分析芯片在负荷状态下产生热应力及应力集中问题,从而更好地考察芯片在工作状态下的可靠性和稳定性。
显微DIC芯片受热膨胀实验
环境条件对芯片可靠性有很大影响,特别是温度过热后,会出现材料软化,结构强度减弱,材料电性能变化,甚至损坏;设备过热,元件损坏,金属材料表面电阻增大等,从而造成芯片无法高效工作。因此芯片的热效应分析非常重要。
如下图所示,在通电受热状态下芯片应变分布特性:
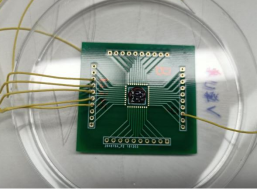
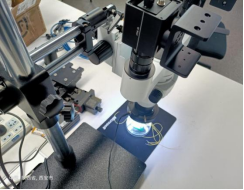
显微DIC系统进行图像采集

芯片通电受热膨胀变形分析


关键点区域应变分布曲线
研究内容及关键点:
显微DIC系统专利的算法可精确测量在显微镜下芯片的细微变形和应变;
显微DIC系统可通过应变云图直接提取温度疲劳载荷过程中影响区域的分布特性,作为失效判定依据;
显微DIC系统应变分析数据结果,可直接用于不同材料热膨胀系数判断依据;
可直接测量 PCB 热变形引起的开胶等失效位置和应变梯度;
手机芯片高低温变形实验
高低温几乎对所有的基本材料都有不利的影响,对于暴露于异常温度下的电子设备,由于温度会改变其组成材料的物理特性,因此可能会改变其工作性能,对手机功能造成暂时或永久的损害。
材料的软化、硬化和脆化
不同材料的收缩不一致
电子器件(芯片、电阻、电容)性能改变
破裂、开裂和脆裂,冲击强度改变,强度降低
芯片和PCB板性能改变
试验测试在不同温度下芯片以及PCB板表面应变情况,分析其对于手机性能的影响。
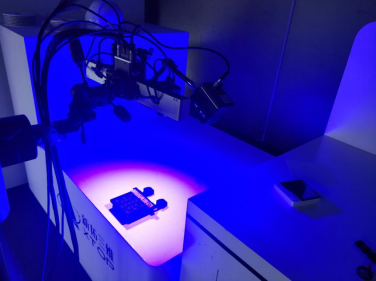
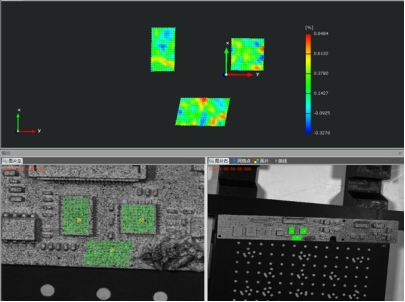

温度变化全过程关键点应变曲线
研究内容及关键点:
DIC技术可测量芯片全场应变,以及温度变化过程中的应变分布变化;
DIC应变云图可直接作为判断关键区域变形以及材料工艺选择依据;
可通过DIC技术获取的应变和应变速率变化,作为验证有限元分析数据依据;
新拓三维XTDIC系统在芯片工艺测试应用:可直接测量芯片及材料热膨胀系数,其测量过程中新拓三维自主研发的算法并结合显微技术,为测试精度提供精确保证。XTDIC系统可直接测量芯片微变形、硅片、封装、基板及材料等热变形效应。测量芯片在不同温度下的力学特性,如高温、低温测试,变形应变分布和应变集中位置。


